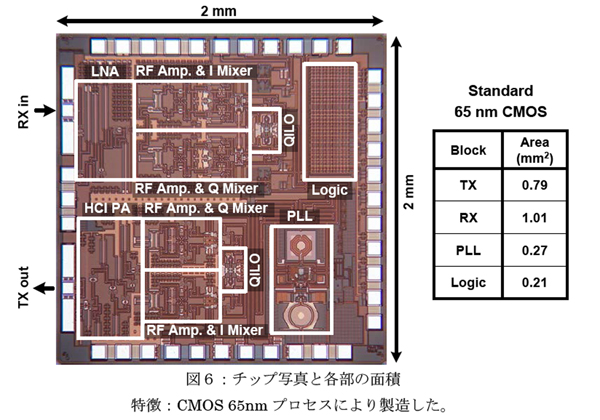 東京工業大学の研究グループは,パルス状の逆電圧を印加するという電気的な手法を用い,ホットキャリア注入現象(HCI : Hot Carrier Injection,MOSトランジスタのドレイン-ソース間電界により加速されたキャリア(ホットキャリア)がゲート酸化膜に注入され,トランジスタの特性が劣化する現象)により劣化したトランジスタの性能を回復させる新技術を開発した(ニュースリリース)。この回復機構をミリ波帯無線機に組み込み,低下した出力電力が回復できることを世界で初めて実証した。
東京工業大学の研究グループは,パルス状の逆電圧を印加するという電気的な手法を用い,ホットキャリア注入現象(HCI : Hot Carrier Injection,MOSトランジスタのドレイン-ソース間電界により加速されたキャリア(ホットキャリア)がゲート酸化膜に注入され,トランジスタの特性が劣化する現象)により劣化したトランジスタの性能を回復させる新技術を開発した(ニュースリリース)。この回復機構をミリ波帯無線機に組み込み,低下した出力電力が回復できることを世界で初めて実証した。
HCIによりトラップされたキャリアは,しきい値電圧の上昇や移動度の低下を引き起こし,結果として電流値が減少する。デジタル回路では動作速度が低下し,アナログ回路では利得が減少するなどの問題を起こし,回路性能を低下させる。経時的に劣化が進むので最終的には動作不良を起こす。HCIはCMOSトランジスタの寿命を決める主要な物理現象の一つ。従来,高温ベークにより劣化を回復する方法があったが,高温ベークのための専用装置が必要だった。
研究グループは,ホットキャリア注入によるダメージを,トランジスタにパルス状の逆電圧を印加するという電気的な手法で回復させることに成功した。パルス状の逆電圧を印加することにより,ゲート酸化膜中にトラップされたキャリアを減少させ,ホットキャリア注入によるダメージからCMOSトランジスタを回復させることができる。
代表的な不揮発性メモリのフラッシュメモリでは,順電圧・逆電圧を印加することにより,ソース・ドレイン間のチャネル領域から,ゲート電極の間に配置された浮遊ゲートへ意図的に電荷を貯めたり抜いたりすることで動作する。研究グループはこのフラッシュメモリーの動作に着想を得て,ホットキャリア注入による酸化膜中の電荷を抜くことができないかと考えた。
最小配線半ピッチ65nmのシリコンCMOSプロセスで試作したトランジスタで試験したところ,トランジスタ単体のドレイン電流を測定すると,ダメージを受けていない状態から,ホットキャリア注入により徐々に電流が減少する。開発した技術を用いると,電流値を回復できることを確認した。
次に,回復機構を実際に組み込んだ60GHz帯ミリ波無線機を,最小配線半ピッチ65nmのシリコンCMOSプロセスで試作した。無線機で必要とされる電力増幅器は,出力電力を高くとるために,大きな電圧振幅が必要であり,特にホットキャリア注入によるダメージを受けやすい回路である電力増幅器としての動作と,回復のための逆電圧印加を可能とする新たな回路構成を考案,小面積で回復機構の実装に成功した。
実験の結果,8.5mWであった出力電力は,HCIダメージにより3.4mWにまで減少した。しかし今回の技術により,6.0mWまで回復できることを確認した。
従来,ホットキャリア注入によるダメージは経時的に蓄積し,製品寿命を決める大きな要因の一つであった。この技術が実用化されれば,製品出荷後においてもホットキャリア注入による性能劣化を回復でき,半導体集積回路製品の長寿命化が期待できるとしている。
関連記事「産総研,電界効果トランジスタの10万倍の寿命を持つトンネルトランジスタを開発」「産総研,トンネルトランジスタの高性能化と長寿命の実証に成功」「東大,超低消費電力トンネル電界効果トランジスタを開発」