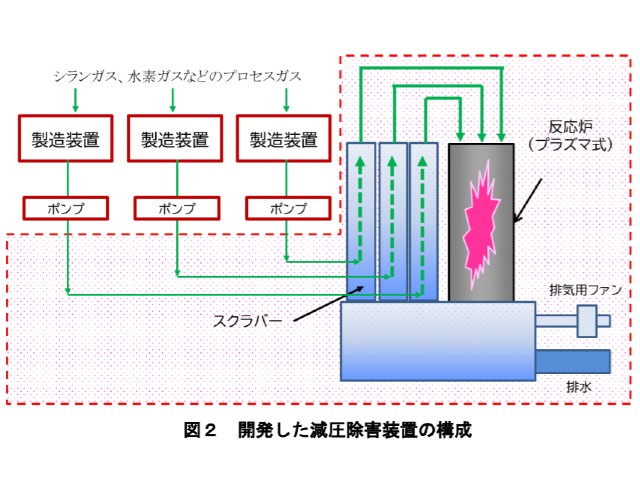 科学技術振興機構(JST)は,東京大学とカンケンテクノに委託した研究成果最適展開支援プログラム(A-STEP)の開発課題「減圧プラズマによる高効率除害装置」の開発結果を成功と認定した(ニュースリリース)。
科学技術振興機構(JST)は,東京大学とカンケンテクノに委託した研究成果最適展開支援プログラム(A-STEP)の開発課題「減圧プラズマによる高効率除害装置」の開発結果を成功と認定した(ニュースリリース)。
半導体やフラットパネルディスプレー,太陽電池などのエレクトロニクス産業の製造工程では,シランガスや水素ガスなど毒性や可燃性を持つ危険なガスを使用する。
現在,これらの危険なガスの無害化には,1000度以上に加熱し分解する熱酸化反応が主に利用されている。例えば,半導体の化学気相合成法(CVD)プロセスで多用されるシランガスは,空気と触れることで爆発的な反応を起こすため,爆発下限界以下の濃度となるように大量の窒素ガスで希釈した上で,高温処理し無害化している。
このプロセスにおいて従来は,加熱手段の効率向上や放熱などの無駄なエネルギーを削減する反応炉の構造の開発にとどまっており,省エネルギーを実現する抜本的な技術開発が重要な課題となっていた。
今回の開発では,爆発下限界が可燃性ガスの圧力に依存することに注目し,希釈ガス量を削減できる圧力条件を検討してきた。デバイス製造装置のポンプ出口から排ガス処理装置に至る配管内を10キロパスカル程度まで減圧することで爆発下限界を引き上げ,化学反応しない環境を作った。
さらに,排ガスを分解する熱源として,通常は大気圧で発生させるアークプラズマを,0.1~10キロパスカル程度の減圧状態でも安定して発生させられる最適条件を見いだした。これにより,減圧状態の排ガス処理装置内にて,アークプラズマ熱源により危険なガスを酸素と熱反応させることで無害化処理を可能とした。
この開発により,エレクトロニクス産業の製造プロセスで大量に使われる窒素ガスを大幅に削減することができる。特にシランガスを用いたCVDプロセスでは窒素ガスによる希釈が不要となる。加えて除害装置に流れ込むガスの総流量も50分の1~100分の1程度になるため排ガス処理のエネルギーの消費を約75%削減できるという。
昨今,大型化するウエハーサイズやディスプレーサイズでは,より多量のシラン系ガスを使用するため,削減できる窒素ガス量が膨大になるとコストおよびエネルギーの削減効果は極めて大きくなる。
また,この技術はシランガス以外の窒素ガス希釈を必要とする可燃性ガスにも,処理条件を最適化することで装置の構成を変えずに容易に適用できるという。例えば,シリコンウエハーの水素処理装置やエピタキシャル成長装置,有機膜のアッシング装置など水素を使用する製造装置へのさらなる応用が期待できるとしている。