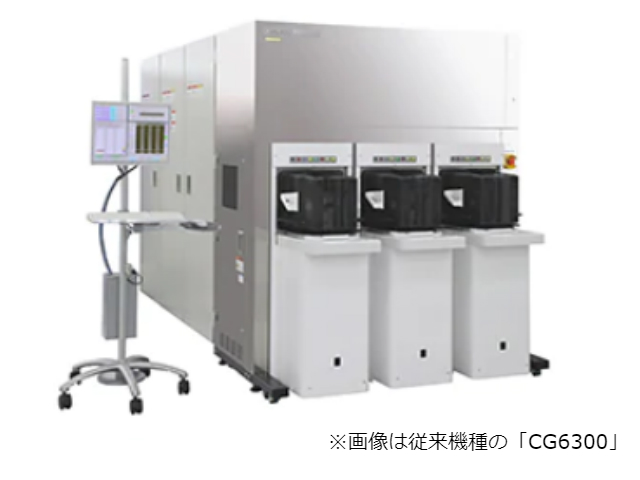 日立ハイテクノロジーズ(日立ハイテク)は,高分解能FEB測長装置(CD-SEM)「CG7300」を開発した(ニュースリリース)。
日立ハイテクノロジーズ(日立ハイテク)は,高分解能FEB測長装置(CD-SEM)「CG7300」を開発した(ニュースリリース)。
「CG7300」は,従来機種「CG6300」と共通のプラットフォームを用いながら高精度な計測性能とスループット向上を実現し,EUV(波長が13.5nmの極端紫外線(extreme ultraviolet)光源)プロセスによる5nm世代デバイスの量産や3nm世代デバイスの開発に対応可能な最新機種となる。
半導体デバイスの加工工程においてはArF(ArFエキシマレーザー光源)による露光技術が用いられてきたが,近年,半導体デバイスの微細化が進むにつれ,先端デバイスメーカーではさらに微細かつ高精度な加工が可能なEUV露光技術を導入し,7nmおよび5nm世代デバイス量産への適用を開始している。
EUVにより加工される回路パターン寸法はArFの約半分になるため,より微細な回路パターンを安定的かつ正確に計測できる技術がプロセス管理において必要とされる。また,EUV露光特有の回路線幅のばらつきや微小欠陥などの課題もあり,微細化に伴い計測ポイント数が増加するため,高スループット化による生産性向上のニーズが高まっている。
CD-SEMは走査電子顕微鏡の応用装置で,ウエハー上に形成された半導体の微細な回路パターンの寸法を高精度に計測できる。今回開発した「CG7300」では,EPE(設計データと実転写パターンのエッジ位置ずれの計測)計測,CD/Roughness(微細パターンの寸法/パターンエッジ位置の局所的なゆらぎ)計測,オーバーレイ計測,低ダメージ計測など従来より定評のある計測性能を向上させ,微細化が進むEUVプロセス量産世代において,高精度で安定な計測を実現する。
また,電子線スキャンシステム,ウエハー搬送システム改良等により,時間当たりのウエハー処理枚数について従来機種比20%以上の高スループット化を実現し,生産性向上に貢献するという。
さらに,「CG7300」は従来機種である「CG6300」との互換性を重視するとともに,装置間の計測値差を最小に抑えることで,量産ラインにおいてより柔軟な装置運用が可能となり,長期間安定した高い稼働率を実現するとしている。