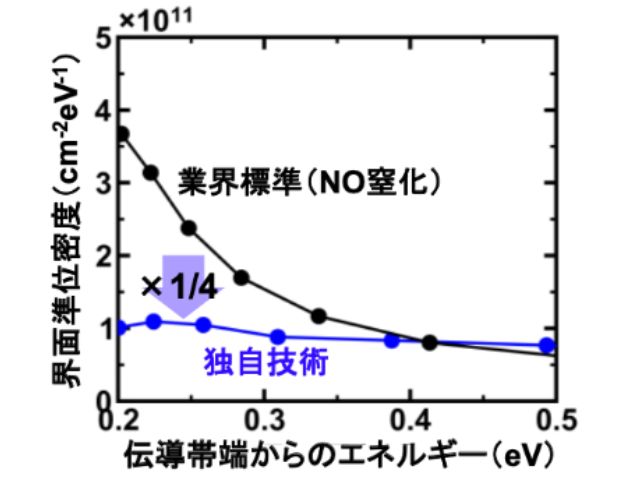 大阪大学の研究グループは,炭化珪素(SiC)パワーデバイスの心臓部となる絶縁膜界面の欠陥を大幅に低減する事に成功した(ニュースリリース)。
大阪大学の研究グループは,炭化珪素(SiC)パワーデバイスの心臓部となる絶縁膜界面の欠陥を大幅に低減する事に成功した(ニュースリリース)。
パワーデバイスは,電力の変換と制御を司り,従来はシリコン半導体を用いて製造されてきた。しかし,その高性能化と高耐圧化が進むにつれ,シリコン半導体の材料物性限界に近づきつつある。
炭化珪素(SiC)は,シリコンと炭素からなる化合物半導体であり,シリコンに対して約3倍のバンドギャップと10倍の絶縁破壊電界強度を有することから,高温かつ高電圧で動作可能な次世代のパワーデバイス用材料として期待されている。
電気自動車や鉄道に搭載されているパワーモジュールは,スイッチング素子と整流素子で構成されており,SiC半導体を用いた整流素子が開発当初から期待通りの性能を示すのに対して,スイッチング素子(SiC MOSFET)の性能は期待値には遥かに及ばない。
具体的には,SiC半導体と絶縁膜との界面を流れる電子の移動度が結晶中の僅か数%程度であり,電力ロスの主要因となっている。これは,絶縁膜/SiC界面に存在する電気的な欠陥が原因。
現在,界面欠陥の低減手法としては,SiO2/SiC構造を形成した後に有毒な一酸化窒素ガス中で高温熱処理して界面に窒素を導入する方法が唯一の実用化技術となっているが,その効果は限定的であり,約30年間にわたって,界面窒化に代わる提案がなされていない。
研究グループでは,高品質な絶縁膜/SiC界面を実現する新技術を開発した。従来手法では,SiO2/SiC界面に後熱処理で窒素を導入していたために,界面窒化層の安定性向上や,界面近傍の電気的な欠陥を十分に低減する事が困難だった。
今回,独自の高密度窒素プラズマ技術を駆使して,SiC表面に緻密で安定な原子層厚の窒化層を形成した後に,この窒化層の構造を損なうことなく,絶縁性に優れたSiO2絶縁膜を堆積する技術を開発した。
これまで,堆積したSiO2絶縁膜は絶縁性に問題があったため,酸素中での熱処理で膜質を改善していた。しかし,この方法では酸素熱処理により界面の窒化層が変質する事が問題だった。
研究グループは,界面構造を保持したまま,SiO2絶縁膜の膜質改善が可能な炭酸ガス(CO2)中での熱処理技術の開発に取り組んでおり,今回の研究成果はこの技術と新提案を融合して達成された。
MOSFETの性能や信頼性の改善によりカーボンニュートラル実現が進展するとともに,SiCデバイスは,高温や放射線環境下での動作特性にも優れている事から,研究グループは,新たな航空宇宙産業や,耐放射線デバイスへの応用が展開されるとしている。