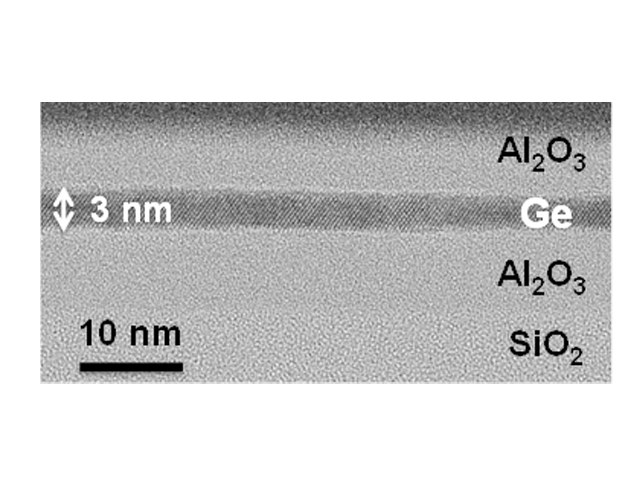 産業技術総合研究所(産総研)は,シリコン(Si)の性能を凌駕する材料として有望視されているゲルマニウム(Ge)の膜厚10nm以下の均一な超薄膜構造の作製法を開発した(ニュースリリース)。
産業技術総合研究所(産総研)は,シリコン(Si)の性能を凌駕する材料として有望視されているゲルマニウム(Ge)の膜厚10nm以下の均一な超薄膜構造の作製法を開発した(ニュースリリース)。
さらにこのナノメートルレベルの均一なGe超薄膜を絶縁膜で挟むと,Ge超薄膜中の電子移動度が著しく向上することを発見した。これは,絶縁膜で挟まれた5nm以下の半導体薄膜では,界面の不均一性や半導体薄膜の膜厚揺らぎの影響によって電子移動度が著しく減少するという,従来の半導体の常識を覆す現象。
Geは,従来の大規模集積回路(LSI)で用いられているSiに比べて移動度が高く,より低電圧で多くの電流を流すことができることから,SiをGeに置き換えることでLSIの高速化が可能になる。
今回,半導体転写技術の高度化により,絶縁膜に挟まれた10nm以下の超薄膜Ge構造を作製できたことは,高速性と消費電力低減が期待されるGeのLSI(Ge-LSI)実現の大きな一歩となる。
さらに,今回発見したGe超薄膜の電子移動度が急激に向上する現象は,高性能超低消費電力Ge-LSI実現だけではなく,新たな電子・光デバイスへの応用展開も期待されるもの。
今回の成果は,Ge-LSI実現に向けて大きな契機となるものだが,その物理的なメカニズムなどはまだ未解明であり,さらなる移動度の向上も期待できるする。
研究グループは,今後2年以内により精度の高い薄膜化プロセスを確立し,移動度向上を実証するとともにそのメカニズムを解明する。また,3年以内に民間企業などへの技術移転を目指すとしている。