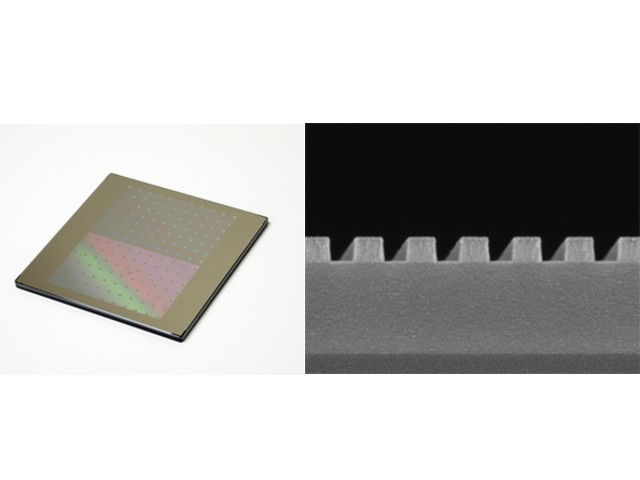 大日本印刷(DNP)は,マルチ電子ビームを使うマスク描画装置を利用し,現在の半導体製造の最先端プロセスであるEUV(Extreme Ultra-Violet:極端紫外線)リソグラフィに対応する,5nmプロセス相当のフォトマスク製造プロセスを開発した(ニュースリリース)。
大日本印刷(DNP)は,マルチ電子ビームを使うマスク描画装置を利用し,現在の半導体製造の最先端プロセスであるEUV(Extreme Ultra-Violet:極端紫外線)リソグラフィに対応する,5nmプロセス相当のフォトマスク製造プロセスを開発した(ニュースリリース)。
EUVリソグラフィは,波長が13.5nmのEUVを光源とすることで,数nmの回路パターンの形成が可能になる。一部の半導体メーカーで,EUVリソグラフィ技術を用いた,5~7nmプロセスのマイクロプロセッサーや最先端メモリデバイス等での実用化が始まっており,今後は最先端プロセスを手掛ける多くの半導体メーカーで利用が拡大すると見込まれている。
同社は2016年に,フォトマスク専業メーカーとして世界で初めてマルチ電子ビームマスク描画装置を導入し,次世代半導体用フォトマスクの描画時間を大幅に短縮するなどの実績がある。
今回同社は,マルチ電子ビームマスク描画装置の特性を活かした新たな感光材料を含むプロセスを独自設計して,EUVマスクの微細構造に合わせて加工条件を最適化することで,フォトマスク専業メーカーとしては初めて5nmプロセスに相当する高精度なEUVリソグラフィ向けフォトマスク製造プロセスを開発した。
マルチ電子ビームマスク描画装置は,26万本の電子ビームを照射することで,高精度なパターニングに必要となる高解像レジストの使用が可能となり,曲線を含む複雑なパターン形状に対しても描画時間を大幅に短縮できるという。また,同装置のリニアステージ(部材を直線的に移動させる土台)は動作安定性が高く,描画精度の向上も実現した。
今後同社は,国内外の半導体メーカーのほか,半導体開発コンソーシアム,製造装置メーカー,材料メーカー等へEUVリソグラフィ向けフォトマスクを提供するとともに,EUVリソグラフィの周辺技術開発を支援し,2023年には年間60億円の売上げを目指す。
また,ベルギーに本部を置く半導体の国際研究機関IMEC(Interuniversity Microelectronics Centre)をはじめとしたパートナーとの共同開発を通じて,3nm以降のより微細なプロセス開発を進めていくとしている。