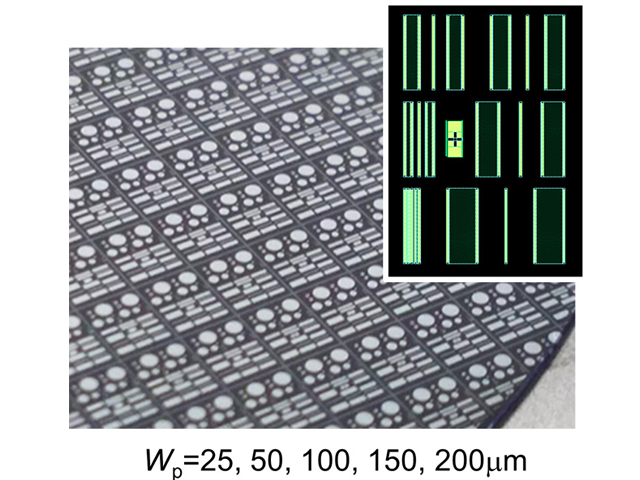 東京工業大学は,ストライプ状に形成したpn接合ダイオードの電流-電圧特性を測定することにより,パワーデバイス用シリコンウエハーの少数キャリア寿命を抽出する新しい評価方法を確立した(ニュースリリース)。
東京工業大学は,ストライプ状に形成したpn接合ダイオードの電流-電圧特性を測定することにより,パワーデバイス用シリコンウエハーの少数キャリア寿命を抽出する新しい評価方法を確立した(ニュースリリース)。
省エネルギー化を進めるためには,パワーデバイスを用いてインバータなどの電力制御システムを高効率化することが必須となる。鉄道や電気自動車など高電圧が用いられる社会インフラ分野ではSi-IGBTが用いられており,今後さらなる高性能化が要求されている。
今回,Si-IGBTの最適製造プロセスの選択を可能とする少数キャリア寿命の電気的評価手法を提案した。Si-IGBTで要求される少数キャリア寿命は長く,耐圧に必要なウエハーの厚さでは,ショックレーのダイオード方程式を用いて導出することは難しい。
そこで,ストライプ状にpn接合ダイオードを形成し,その電流-電圧特性を測定することで,少数キャリア寿命を抽出するテストパターン(Test Element Group,TEG)を構築した。この構造では先に記したように少数キャリアはウエハー裏面に到達しにくくなるが,pn接合ダイオードの測定からストライプの間隔依存性を解析することにより,少数キャリア寿命を得ることができる。
デバイスシミュレーターを用いた数値計算では,電流-電圧特性に明瞭なストライプの間隔依存性が見られた。特性に変化がなくなる十分広い間隔をWp,maxパラメータと定義したところ,設定した少数キャリア寿命との関係式を得ることに成功した。
こうした知見により,次世代のSi-IGBTに用いるゲート絶縁膜形成プロセスの評価を行なった。比較した製造プロセスは,1,050℃で13分間と1,100℃で5分間の2工程。また,用いるウエハーの少数キャリア寿命を知るため,ゲート絶縁膜形成プロセスのない試料を参照にした。
この手法でpn接合ダイオードの測定と得られたWp,maxパラメータによる解析を行なった結果,ダイオード試作のみのウエハーでは少数キャリア寿命が60μ秒だったのに対し,1,050℃で13分間の酸化工程では33μ秒,1,100℃で5分間の酸化工程は18μ秒と劣化することが分かった。以上の結果から1,050℃で13分間の酸化工程がより適している試作プロセスであることを明らかにした。
この手法の利点として,Si-IGBTと同じウエハーに作りこむことができるため,実デバイスに近い少数キャリア寿命の評価が可能となる点が挙げられるという。また,ワイドバンドギャップ半導体で研究されている超高電圧のデバイス評価にも展開が可能だとしいている。