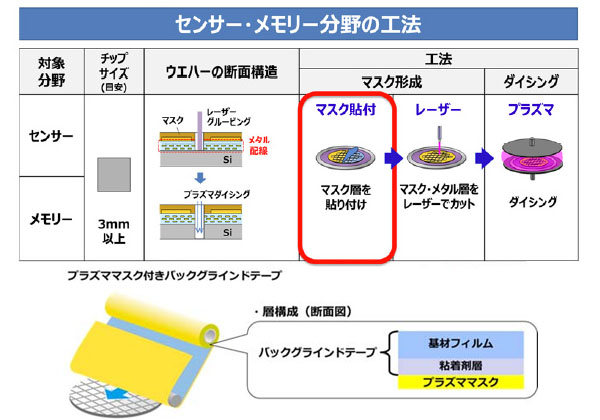 古河電気工業は,「レーザーグルービング(溝加工)+プラズマダイシング工法」向けの新たな半導体用テープ「プラズママスク付きバックグラインド(BG)テープ」及び「エキスパンド分割用ダイシング・ダイアタッチフィルム(D-DAF)」の開発に成功した(ニュースリリース)。2017年度下期より本格的な量産を開始する。
古河電気工業は,「レーザーグルービング(溝加工)+プラズマダイシング工法」向けの新たな半導体用テープ「プラズママスク付きバックグラインド(BG)テープ」及び「エキスパンド分割用ダイシング・ダイアタッチフィルム(D-DAF)」の開発に成功した(ニュースリリース)。2017年度下期より本格的な量産を開始する。
半導体チップの更なる薄化が求められていることから,半導体ウェハーは更に薄膜化する必要があり,これを実現すべく様々な製造方式が提案されている。特に半導体ウェハーから半導体チップ毎に切断する製造工程(ダイシング)では,プラズマを照射して切断する「レーザーグルービング(溝加工)+プラズマダイシング工法」が機械的な加工方式に比べて歩留や品質面で優れている。
同社は,「レーザーグルービング(溝加工)+プラズマダイシング工法」向け部材として,新たに半導体用テープ「プラズママスク付きバックグラインド(BG)テープ」及び「エキスパンド分割用ダイシング・ダイアタッチフィルム(D-DAF)」の開発に世界で初めて成功した。
「プラズママスク付きバックグラインド(BG)テープ」は,半導体ウェハーのバックグラインド時のウェハー表面保護機能及びプラズマ照射時におけるウェハー表面保護機能の両方を併せ持つテープ。バックグラインド(BG)工程においては通常のBGテープと同様に半導体ウェハーの薄膜化研削ができ,更にBG後はBGテープのみを剥離し,ウェハー表面にプラズママスクの層を残す事で,プラズマ照射から表面を保護するためのマスク層を形成する。
このプラズママスク層は,プラズマダイシング時のエッチング用ガスに対する耐性を持つため,プラズマダイシング時はマスク層としてウェハー表面を保護する。又,プラズマダイシング後,ガス種を切り替える事で耐性が無くなるため,完全に除去する事が出来る。
「エキスパンド分割用ダイシング・ダイアタッチフィルム(D-DAF)」は,プラズマ照射による切断後に,ダイシングテープをエキスパンドする事でダイアタッチフィルム(DAF)を分割する。DAF分割性が良好なため,容易に半導体チップ+DAFのピックアップを可能とする。
いずれの製品もBGテープラミネート~BGテープ剥離,エキスパンド分割~ピックアップ工程における装置は,従来のものがそのまま使用できるとしている。