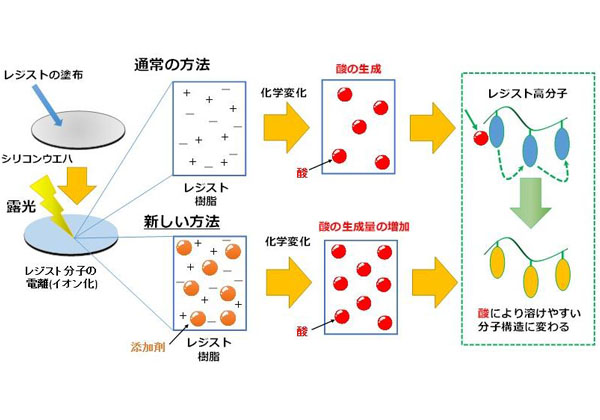 北海道大学と大阪大学は,ナノ構造体形成についての研究の成果として,半導体製造用材料であるレジスト材料の加工性能を大幅に改善する方法の開発に成功した(ニュースリリース)。
北海道大学と大阪大学は,ナノ構造体形成についての研究の成果として,半導体製造用材料であるレジスト材料の加工性能を大幅に改善する方法の開発に成功した(ニュースリリース)。
現在のフォトリソグラフィプロセスでは,化学増幅型レジストが用いられ,EUVリソグラフィに対応できる高性能のレジスト開発が行なわれている。
研究グループでは,これまでEUVなど電離放射線で引き起こされるレジスト中での化学反応を,加速器からの電子線を使ったパルスラジオリシスと呼ばれる高速時間分解実験を行ない,追跡してきた。その結果,添加剤によってレジスト中の脱プロトン反応の効率化が可能であることを明らかにし,実際のレジストへの添加効果を調べてきた。
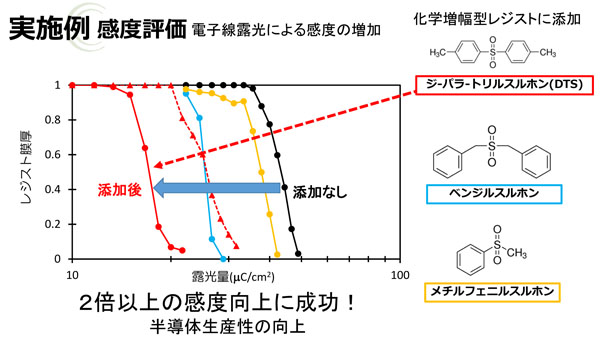 そして今回,化学増幅型レジストへの露光によって生成する酸の収率を増加させることのできる,スルホン化合物の添加剤を初めて見出した。この手法は,レジストに添加剤を加えるだけで良く,1台1億ドル以上といわれる露光機の改造やプロセス数の増加などを伴わず,極めてシンプルで現行のプロセスと適合性が高いもの。
そして今回,化学増幅型レジストへの露光によって生成する酸の収率を増加させることのできる,スルホン化合物の添加剤を初めて見出した。この手法は,レジストに添加剤を加えるだけで良く,1台1億ドル以上といわれる露光機の改造やプロセス数の増加などを伴わず,極めてシンプルで現行のプロセスと適合性が高いもの。
研究では,ジ-パラ-トリルスルホンをレジストに添加したところ,電子線露光において2倍以上感度が向上した。これにより露光時間を1/2程度まで減らすことが可能となり,少ないエネルギーの露光によってクオリティの高い加工プロセスを行なえるようになる。
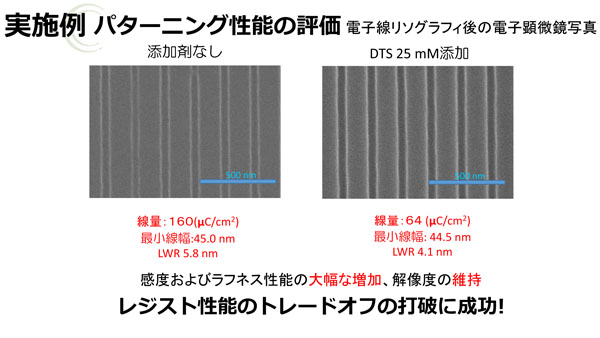 これは,レジスト材料の高感度化の際に問題であった最小加工寸法(解像度)やラフネスの悪化といったトレードオフの問題を解決する画期的な手法となるもの。EUVリソグラフィの問題点である生産性を向上させ,次世代の半導体微細化,高性能化を実現することができる。
これは,レジスト材料の高感度化の際に問題であった最小加工寸法(解像度)やラフネスの悪化といったトレードオフの問題を解決する画期的な手法となるもの。EUVリソグラフィの問題点である生産性を向上させ,次世代の半導体微細化,高性能化を実現することができる。
研究グループは,現行のレジスト材料に適用することにより露光時間の短縮が可能なので,産業界のみならず,電子線リソグラフィ等の微細加工を利用した研究の効率化に寄与することができるとしている。