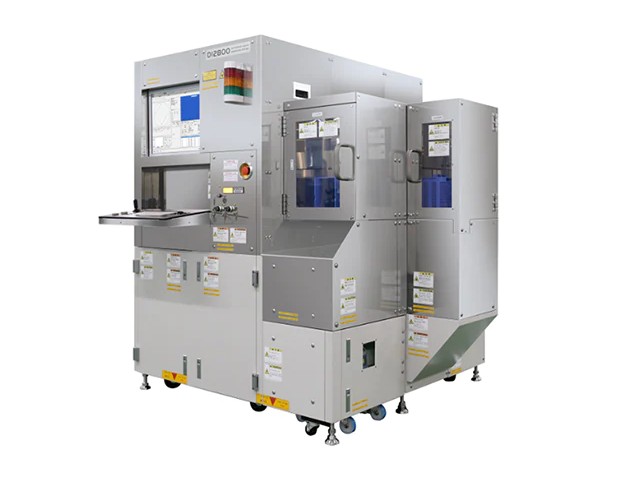 日立ハイテクは,半導体デバイスの欠陥検査に必要な暗視野式ウエハー欠陥検査装置 「DI2800」を発売する(ニュースリリース)。
日立ハイテクは,半導体デバイスの欠陥検査に必要な暗視野式ウエハー欠陥検査装置 「DI2800」を発売する(ニュースリリース)。
近年,通信高速化(5G)や自動車の電動化が新しい社会基盤技術として浸透するのに伴い,IoT分野や車載用の半導体デバイスも数多く使用されるようになったが,こうした半導体デバイスは高い信頼性や安全性が求められる。
従来の半導体デバイス製造工程では,プロセス管理や歩留まり向上を目的とした抜き取り検査が実施されていたが,IoT分野や車載用の半導体デバイスでは,高い信頼性と安全性を担保するために全数検査を実施し,製造工程中で良品と不良品を判定する検査が必要となる。特に,ウエハーの欠陥検査装置は,高感度かつ高速に全数検査が実施できる処理能力が求められていた。
同社はこのニーズに応え,暗視野式ウエハー欠陥検査装置を開発した。この製品は,散乱強度シミュレーション技術を活用した照明および検出光学系の最適化により,製造工程中のパターン付きウエハー上の欠陥を高感度に検査可能で,その検出感度は鏡面ウエハー上の0.1μm標準粒子検出を実現しているという。
また,従来はデータ処理上高感度検査の難しかった0.3mm角などの非常に小さな半導体チップに対しても0.1μm感度で検査が可能となり,さらには検査シーケンス最適化により200mmウエハー上の欠陥検査で40枚/時間以上の処理性能を実現したとする。
同社は,この製品を既に販売している高分解能FEB測長装置「CS4800」と欠陥形状評価SEM「CT1000」と組み合わせることで,IoT分野や車載用の半導体デバイスの開発・量産における検査・計測工程での多様なニーズに対応する。今後,各装置から検査・計測したデジタル情報を紐づけ・集約した上で解析し,新たな付加価値を提供するデータソリューションの提案も行なうとしている。