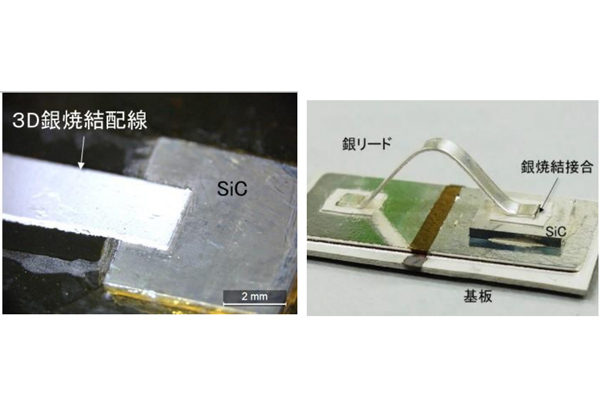 大阪大学の研究グループは,独自開発の銀粒子焼結により,次世代パワーエレクトロニクスの高性能3D配線を低コストに実現する技術を開発しまた(ニュースリリース)。
大阪大学の研究グループは,独自開発の銀粒子焼結により,次世代パワーエレクトロニクスの高性能3D配線を低コストに実現する技術を開発しまた(ニュースリリース)。
銀粒子焼結技術は同大が開発した技術だが,200℃程度の低温(他の金属粒子は融点の9割程度で焼結する,銀の融点は 962℃)で銀粒子焼結が形成されるメカニズムはこれまで不明だった。
今回,銀粒子が低温で焼結になるメカニズムが『ナノ噴火現象』であることを解明し,200℃程度で大気中の酸素と反応しながらAg-O液体噴火することで金属焼結が進むことを示した。これは,銀のみで生じる現象で,金や銅などの他の金属では不可能。銀は,金属の中で最も電気伝導と熱伝導が良く,ダイアタッチや配線材料として適している。
今回,研究グループは,基板に実装されたSiCダイの表面に,凹凸に応じた3D配線を安価な印刷により形成し,250℃の低温で大気中無加圧で焼成することで5×10-6Ω・cmの低抵抗を実現した。
これにより,従来のワイヤボンドのようにSiCダイに負荷を掛けることなく低抵抗配線が形成でき,さらに低ノイズ化が安価に実現し,次世代ワイドバンドギャップ・パワー半導体の実用化に拍車が掛かるとしている。