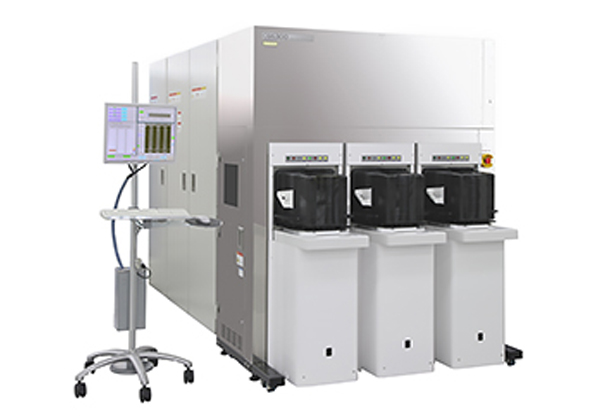 日立ハイテクノロジーズ(日立ハイテク)は,高分解能測長装置の最新機種 「CG6300」を開発した(ニュースリリース)。2015年10月に発売を開始する予定。
日立ハイテクノロジーズ(日立ハイテク)は,高分解能測長装置の最新機種 「CG6300」を開発した(ニュースリリース)。2015年10月に発売を開始する予定。
日立ハイテクの高分解能FEB測長装置は,累計出荷台数4,600台を売り上げるなど,デファクトスタンダードとなるまで成長を遂げてきた。新製品はフルモデルチェンジを行ない,7nm世代デバイス開発と10nm世代デバイス量産時のプロセスコントロールに対応した。
近年,先端デバイスメーカは7nm世代デバイスの開発と10nm世代デバイスの量産に着手しており,その微細化の手法として,液浸露光機によるLELELEの繰り返しや液浸露光機と成膜・エッチング装置などによるSAQPのマルチプルパターニングが主流となっている。
一方で,FinFETや3D-NAND,DRAMでは,構造の三次元化やハイアスペクト化により,深い溝や穴底の寸法計測の正確性が求められている。また微細化に伴うマスク数および検査工程数の増加が,先端デバイスメーカの課題となっている。
高分解能FEB測長装置は走査型電子顕微鏡の応用装置で,ウェーハ上に形成された半導体の微細パターンの寸法を高精度に計測する。新製品では,電子光学系を一新することにより分解能を高め,測長再現性および画質の向上を図った。
電子顕微鏡カラムは,材料から検出される二次電子(SE)または後方散乱電子(BSE)を,計測対象によって選択可能とすることで,BEOL工程のVia-in-trenchや3D-NAND,DRAMにおける深い溝や穴底の寸法計測を実現した。
さらに電子ビームの走査速度を従来比2倍とすることでウェーハ表面での帯電影響を低減し,より高分解能画像の取得と高コントラストによるエッジ検出が可能となった。
また新設計ステージにより,時間当たりのウェーハ処理枚数について従来比20%以上の高速化を図ることで生産性を高めた。加えて,デバイス量産化に対応するため,装置間差を最小に抑え,長期間安定した高い稼働率を実現している。





























