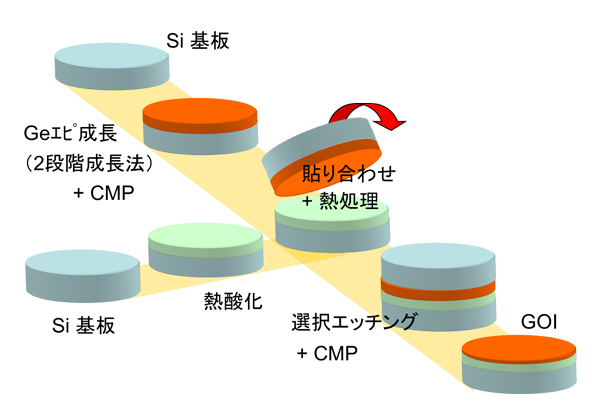 東京都市大学の研究グループは,半導体集積回路のシリコンに代わる超低消費電力化も可能な絶縁膜上の大面積ゲルマニウムウエハーを作製する新技術の開発に成功した(ニュースリリース)。
東京都市大学の研究グループは,半導体集積回路のシリコンに代わる超低消費電力化も可能な絶縁膜上の大面積ゲルマニウムウエハーを作製する新技術の開発に成功した(ニュースリリース)。
今日の高度情報化社会を支えるLSIはSiをベースに作られており,社会の発展にはこの分野の継続的な発展が不可欠となる。しかし今この微細化に限界が訪れると同時に,消費電力の増大が差し迫った課題となっている。
そんな中,次世代材料として,Siに似た結晶構造,電子構造を有するGeが期待を集めている。Geは材料特性においてSiよりも移動度が格段に高いことからLSIを高性能化できるのみならず,歪みによって発光することから集積回路内の光配線化を実現でき,高効率光デバイスの作製を可能とする。
しかし,実用化に向けたコスト削減に必須となる大面積ウエハーをGeで作ることは非常に難しく,これまでSi基板に匹敵する大面積で高品質のGe基板を作製する技術は開発されていなかった。
今回,研究グループが開発に成功したGeウェハー作製手法は,この大面積化,超高品質化を可能にするもの。具体的には高品質Ge薄膜をSi基板上に結晶成長させ,さらにこれを絶縁膜上に貼り合わせたうえで,選択エッチングによって上部層(Si基板)を取り除き,高品質な縁膜上のGeウエハー(Ge-on-Insulator:GOI)GOIを得た。
この手法の大きな特長は,まず高価なGe基板を一切使わないことにあり,GeのSi基板上への高品質結晶成長をキーテクノロジーとする。
特に2段階成長法を確立したことにより,4%の格子定数差による欠陥を後の工程で上側に位置させ,エッチングにより除去して完全に解消することができる。
また,結晶成長膜であるがゆえ,素子の特性向上に好都合な結晶歪みを持たせることができ,歪みを持ったGOIが形成可能となる。この歪みを有する膜は,発光素子やレーザー応用に有効なことから,集積回路内の光配線を実現可能にする。
さらにこの手法では,SiGeエッチングストップ層の導入により,エッチングによるGeの膜厚調整を結晶成長段階に設定でき,大面積ウエハーの全面で超薄膜かつ均一なGOIが実現可能だとしている。なお,電気測定により,このGOIのGe基板に匹敵する品質を確認したという。
この技術により,これまでの半導体技術の進展を継続することが可能となるとしている。実際には,LSI内部のデバイスを,SiからGeへ替えるという大革新を起こすことになり,限界が迫るシリコン技術の壁を打ち破る技術となる。
電子デバイスの高速化と光配線の導入によって,消費電力量は一桁下がることを見込む。そのため,後10年から15年のエレクトロニクス技術,高度情報化社会のますますの継続的発展を可能にすることになるとしている。
今後は数年以内に国内基板メーカーとの大面積GOI基板共同開発,商品化を目指し,台湾など国外大手半導体メーカーへの供給を狙っていく。
さらにこの技術は,プラスチックなどのフレキシブル基板上へもGe膜を形成できることになるので,フレキシブル基板上Ge光電子融合型デバイスを実現することで,各種センサー,ウェアラブルデバイスへの応用が期待でき,医療メーカー,ヘルスケアメーカーなどターゲットを広げていく予定。
関連記事「東洋炭素ら,低欠陥SiCウエハー製造法を開発」「NICTら,酸化ガリウムエピウエハの開発に成功」「東北大ら,高品質低コスト単結晶シリコンを開発」






























