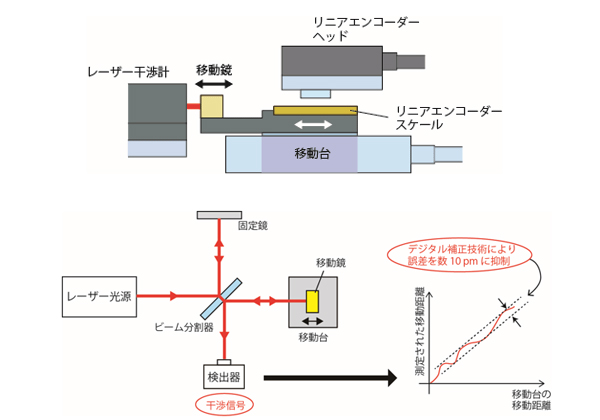 産業技術総合研究所(産総研)とニコンは共同で,リニアエンコーダ(高精度加工機械などに組み込まれる「ものさし」)の高精度化に取り組み,ナノメートル以下の誤差の目盛を実現した(ニュースリリース)。
産業技術総合研究所(産総研)とニコンは共同で,リニアエンコーダ(高精度加工機械などに組み込まれる「ものさし」)の高精度化に取り組み,ナノメートル以下の誤差の目盛を実現した(ニュースリリース)。
リニアエンコーダは,1nm以下の高分解能の「ものさし」であり,表面に刻線のある基板と読取り装置との組み合わせで,長さや位置を正確に測定できる。表面に刻線のある基板には数~数十µmの間隔で凹凸の刻線があり,その間隔を読取り装置で読取り,さらに電気的に等間隔に分割することで高分解能の目盛を得ている。
これらの目盛は等間隔に並んでいるが,微視的には歪みが生じているため,これまでナノメートルオーダーの誤差は避けられなかった。しかし,半導体素子や光学素子などに要求される加工精度が年々高まっているため,目盛の誤差を1nm以下に抑えることが求められていた。
ニコンではリニアエンコーダの1nm以下の目盛の誤差を目指し改良を進めてきている。しかし,従来の変位計ではナノメートルオーダーの誤差は評価できないため,新たな評価手法を探していた。これに対し産総研では光の干渉を利用した変位計の開発をこれまで行なっており,十分な正確さ(0.1nm以下の誤差)での長さ測定技術を既に確立していた。
産総研で開発したリニアエンコーダの誤差評価装置は,レーザ干渉計と移動台から構成される。評価するリニアエンコーダの「ものさし」部分(スケール,表面に刻線のある基板)は,水平方向に移動する移動台の上に設置されており,移動台に向かい合う形で設置されている読取り装置(ヘッド)で刻線の間隔を読みとり,電気的に分割した目盛が得られる。
移動台の端には,レーザ干渉計の移動鏡が設置されており,移動台の移動距離が計測できる。リニアエンコーダの読取りとレーザ干渉計による移動台の移動距離の測定を同時に行ない,測定結果を比較することで誤差を評価した。
リニアエンコーダのヘッドからはスケールに向かってレーザ光が照射されており,スケールによる回折光をヘッドで検出してスケール表面の刻線の間隔を読取る。ニコンのスケールには4µmの間隔で刻線があり,ヘッドでは2つの検出器を使用しているため,刻線間隔の2分の1(=2µm)が読取られる。
さらに読取られた間隔を電気的に千分の1~10万分の1に分割し,目盛を取得する。ヘッドは固定されており,スケールだけが水平方向に移動するため,移動台の移動距離を目盛の間隔を基準に測定することができる。
レーザ干渉計では,移動台に設置した移動鏡に,レーザ干渉計からのレーザ光を照射し,反射光が元のレーザ光と干渉計内で重なり合うことで発生する光の干渉信号を検出する。干渉信号の明暗は移動鏡がレーザ光の波長の2分の1を移動する毎に繰り返すので,光の波長を単位として正確に移動距離を測定できる。
産総研では,このレーザ干渉計の鏡やプリズムといった光学部品が不完全であることから生じる干渉信号の歪みを,デジタル信号処理を駆使した補正技術を使って極限まで抑制した。これにより,誤差が数10ピコメートル以下の変位計を実現している。
今回,この誤差評価装置を用いて,ニコンが開発したリニアエンコーダの目盛の誤差を評価した結果,刻線の読取りと電気的な分割の手法に新しい方式を用いて周期誤差を大幅に低減したことで,移動台の移動範囲(14µm)に渡って周期誤差が±0.3nmであることを実証した。
今回のリニアエンコーダは今後,ニコンによって各種の高精度加工機械に組み込まれ,これまでより高度な半導体素子や光学素子の製造現場などで使用されることになる。レーザ干渉計による誤差評価装置は,リニアエンコーダ以外の長さ測定装置の評価へも簡単に応用できるため,産総研において市販の変位計の誤差評価サービスの供給などに利用するとしている。































